
プラズマについて解説します!
今回は、半導体プロセスの「プラズマ」について解説していきます。
プラズマについて全く知らない方、異分野から半導体製造工程に関わることになった方など、初心者向けの記事になります。
・プラズマの意味を知りたい。
・半導体の製造工程に関わることになった
・プラズマについて調べたけど、イマイチ分からない
目次
プラズマとは?
プラズマの意味
プラズマとは気相中の原子やイオンなどが電離し、全体の電荷が中性になっている状態です。
言葉だけでは想像しにくいと思いますので、以下にプラズマのイメージ図を示します。

プラズマ状態では、マイナスの電荷を持つ電子と、プラスの電荷を持つ陽子、中性分子(原子)、ラジカルなどが混在しており、非常に反応を起こしやすい状態です。
プラズマは、固体・液体・気体に継ぐ第4の物質の状態で、以下のような特徴を持っています。
・光や電磁波を発生させる
・電気を流す
・低温でも高いエネルギーを持つ
・反応性が高い
これらプラズマの特徴は、半導体プロセスと非常に相性が良く、多くの場面で活用されています。
それでは、次項では半導体プロセスに於けるプラズマの発生過程について解説していきます。
プラズマの作り方(半導体プロセス)
プラズマを発生させるためには、大きく2つの方法があります。
①高温プラズマ
⇨ガスを高温(1000℃以上)にする。
②★低温プラズマ
⇨ガスに高電界を印加する。半導体プロセスに使用されている。
半導体プロセスでは、低温プラズマ(グロー放電)が利用されています。
それでは、低温プラズマの発生過程について、図を用いて解説していきます。
※今回は理解しやすくするために、電子、陽イオン、原子の3種類の要素のみで解説していきます。
A.まずは、高電界を印加した時の電子の動きを見ていきます。

マイナスの電荷を持つ電子は、プラス側に引き寄せられ加速していきます。
B.続いて、電子がガス原子に衝突した時の反応です。

加速した電子がガス原子に衝突すると、ガス原子の最外殻から電子が飛び出すので、衝突した電子と合わせて電子は2つになり、マイナスの電荷を失ったガス原子は陽イオンになります。
C.Bで2つに増えた電子は、高電界によって加速して、再び原子へ衝突するということを繰り返すので、陽イオンと電子の数はなだれ的に増加していきます。

D.Cで陽イオンと電子の数がある閾値を超えると、プラズマが形成されます。

以上がプラズマの作り方となります。
補足として、ラジカルという言葉について少し述べます。
プラズマの発生過程にラジカルという言葉が登場します。
ラジカルとは、分子が乖離して結合手が余っている状態で、例えば、H2水素分子が乖離した場合、Hが水素ラジカルということになります。
イオンは陽子と電子の数が異なる状態ですので、イオンとラジカルは違います。
続いて、次章では半導体プロセスでのプラズマの活用例を紹介していきます。
半導体プロセスのプラズマとは?
①プラズマアッシング
まずは、プラズマアッシングです。
アッシングとは、灰にするという意味の英語から来ています。
フォトリソグラフィの工程でマスクとして形成したレジストを、酸素プラズマガスによりアッシング(炭化)して取り除きます。
フォトリソグラフィの工程については、以下の記事で解説しています。
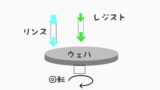
② プラズマエッチング
続いては、プラズマエッチングです。
エッチングとは、シリコンウェハ表面に成膜された膜を取り除くことです。
高真空で材料ガスをプラズマ化して、化学反応と加速したイオンで膜を削って除去します。
エッチングの工程については、以下の記事で解説しています。
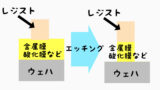
③ プラズマ化学気相成長
最後に紹介するのは、プラズマ化学気相成長です。
プラズマCVDとも呼ばれ、材料ガスを高周波電界などによりプラズマ化して、化学反応により薄膜を形成する手法です。
熱による酸化膜形成などと違い、250℃〜400℃程度の比較的低温で成膜することができます。
以上、半導体プロセスでのプラズマ活用例でした。
次章では、半導体プロセスでプラズマを利用する理由について解説します。
半導体プロセスでプラズマを利用する理由
①低温で反応させられる
プラズマを利用することで、低温で種々の反応を起こすことが出来ます。
高温にすれば、大きなエネルギー反応を起こすことができますが、高温化ではウェハ上の構造がぐちゃぐちゃになったり、予期せぬ化学反応が起こることがあります。
プラズマ反応のメインである電子は、質量が小さく、104K以上の高温に相当するエネルギーを持ちます。
電子が、ガス分子などの解離、励起を起こすのに十分なエネルギーを持っており、ガス温度が装置温度に近いので、低音で種々の反応を起こすことが出来るのです。
②制御が容易である
プラズマには、制御が容易という特徴があります。
例えば、半導体プロセスのエッチングには、プラズマを利用するドライエッチングと、液体の化学反応を利用するウェットエッチングがあります。
ドライエッチングは、ウエットエッチングに比べて誤差なく膜を削ることが出来ます。
制御性が悪いと、目的とするエッチングが未完で材料が残っていたり、逆にエッチングすべきで無い部分をエッチングしてしまったりする可能性が出てきます。
制御性の観点から、現在使われているエッチングの9割以上はドライエッチング(プラズマが利用されている)です。
以上、半導体プロセスの「プラズマ」についての説明でした。
ハナハナが参考にしている半導体関連本
最後まで読んで頂き、ありがとうございました。
☆この記事が参考になった方は、以下のブログランキングバナーをクリックして頂けると嬉しいです☆⬇︎






コメント